Park NX Hybrid WLI 全自動工業 WLI-AFM 系統
將白光干涉測量引入AFM技術,用於半導體計量
Park NX Hybrid WLI是一款具有內置WLI輪廓儀的AFM,用於半導體和相關製造質量保證。例如半導體前端、後端到高級封裝的過程控制,以及研發計量。它適用於那些需要在大面積上進行高吞吐量測量的設備,這些設備可以縮小到具有亞納米分辨率和超高精度的納米級區域。
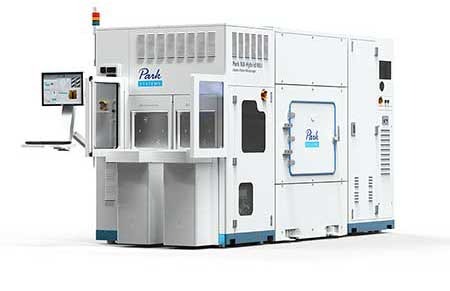
半導體計量的兩種互補技術
WLI:白光干涉測量是一種光學技術,它可以對非常寬的區域進行成像,速度非常快,滿足高吞吐量測量。
AFM:原子力顯微鏡是一種掃描探針技術,即使對透明材料也能提供精準的納米級分辨率測量。


NX-Hybrid WLI 功能
Park WLI系统
- Park WLI支持WLI和PSI模式(PSI模式由電動過濾器變換器 支持)
- 可用物鏡放大倍數:2.5X、10X、20X、50X、100X
兩個物鏡可由電動線性換鏡器自動更換
兩個物鏡可由電動線性換鏡器自動更換
WLI光學干涉測量
掃描Mirau物鏡高度時,由干涉引起的光強變化可以計算每個像素處的樣品表面高度
白光干涉測量 (WLI) 和相移干涉測量 (PSI) 是兩種常用的表面表徵技術
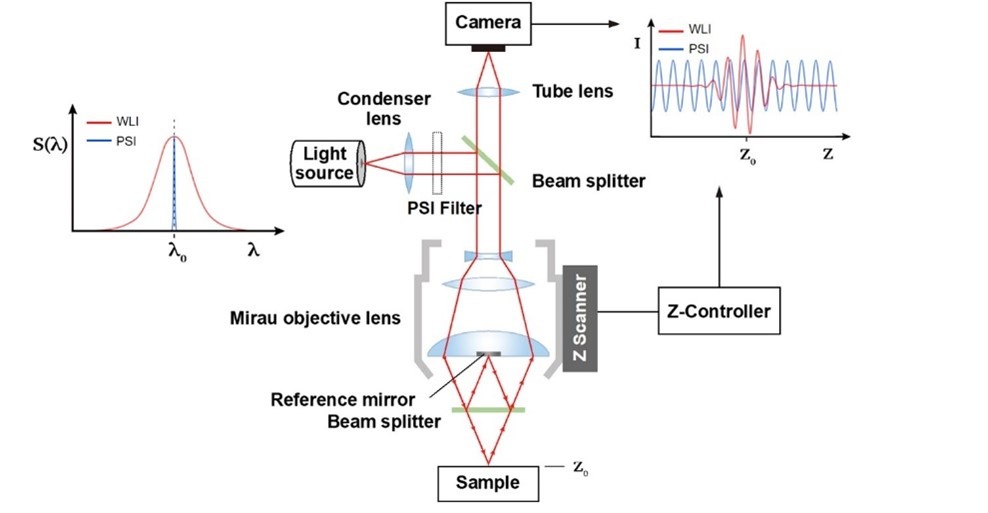
NX-Hybrid WLI應用
熱點檢測和審查/熱點快速調查和熱點缺陷自動審查
可以通過比較參考和目標樣品區域的圖像來檢測圖案結構的熱點
WLI的高速“熱點檢測”可以快速定位缺陷位置,以進行高分辨率AFM審查

